
UBM(Under Bump Metallurgy,亦稱 Under Bump Metal 或 Under Barrier Metal)是形成於半導體晶圓電極(Pad)上的金屬層,能夠賦予錫球(solder bump)與晶片電極(pad)之間良好的接合性,是覆晶封裝(Flip Chip)中不可或缺的關鍵結構。
此外,UBM同時也被廣泛地應用於打線接合(Wire bonding)之強化,提升接合可靠性。因此,UBM亦被稱為OPM(Over Pad Metal)或FSM(Front Side Metal)。
而使用無電鍍(無電解鍍)─化學鍍(E-less/electroless plating)方式之製程則為本公司UBM代工服務(半導體鍍膜)之特色,透過本公司化鎳金(NiAu/ENIG)及鎳鈀金(NiPdAu/ENEPIG)之化鍍製程,能有效地在晶圓電極上形成一層金屬化鍍膜。
UBM 技術廣泛應用於高可靠性需求的領域,包括車用電子(如 ADAS、電動車 EV)、通訊(5G/6G)、醫療設備與工業應用等。
| (標準值) | |
|---|---|
| 晶圓材質 | Si、SiC、GaN(其他材質之晶圓亦可提供服務) |
| 晶圓尺寸 | ≤ 300mmφ(≤ 12”) |
| 晶圓厚度 | 150µm以上(150µm以下請洽本公司) |
| Pad材質 | 純Al、AlSi、AlCu、AlSiCu、Cu、Au |
| Pad形狀 | 方形、圓形、其他形狀 Min.4µm□ 開口 |
| 晶圓種類 | 邏輯、記憶體、功率電晶體、MEMS等 |
| UBM | E-less Ni/Au、E-less Ni/Pd/Au(本公司使用無鉛、無氰化鍍液) E-less Cu plating(開發中) |
| Ni(material) | Ni(P5~10%) |
| Ni膜厚 | 1.5~5.0µm:Pad之間有間隔限制 |
| Pd膜厚 | 0.05~0.2µm |
| Au膜厚 | 0.02~0.05µm(Ni/Pd/Au) 0.05~0.20µm(Ni/Au) |
| 膜厚偏差 | ±10%以下(200mmφ) |
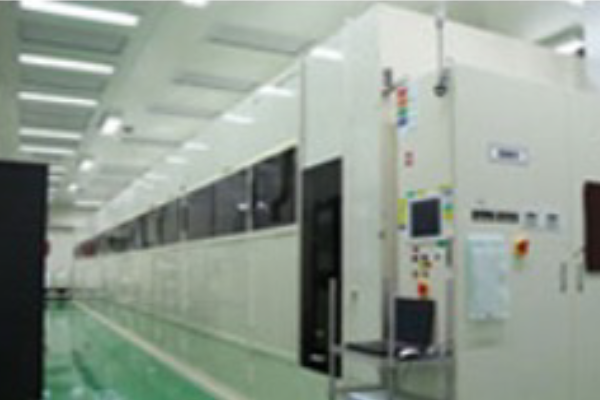
~12吋化鍍產線(龍潭1號機)

| 分析類型 | 使用儀器 |
|---|---|
| 表面形貌觀察 | FIB-SEM、FE-SEM、SPM |
| 表面元素分析 | FE-EPMA、FE-AES、XPS |
| 表面官能基分析 | Raman、FT-IR、UV |
| 金屬、晶體結構分析 | XRD |
⇒以我們在半導體領域累積之豐富Know how,為您提供表面構造與元素分析服務
克服IC為人所詬病之電位差、Pad種類與面積差異所導致之高度偏差問題
本公司之UBM化鍍代工藉由特別講究之獨家添加劑及化鍍方式, 大幅降低Pad電位差、面積差異所導致之高度偏差。

較小Pad亦能均勻化鍍縱使Pad之間電位相異,亦能化鍍至幾乎同等之膜厚水準
藉由抑制無電解Au化鍍之孔蝕,以強化其焊點接合性
本公司之Au化鍍液不含氰,並在加入特殊添加劑後相當成功地抑制了Au化鍍層之孔蝕,進而確保其良好的焊點接合性, 同時我們也將化鍍處理液及化鍍膜之分析結果回饋至化鍍液開發端,借此強化其焊點接合性。
打線接合(Wire bonding)強度上也能充分展現其可靠度
本公司化鍍之功效並不僅止於覆晶技術(Flip Chip)而已,當其作為打線接合(Wire bonding)之Bond Pad 接合面基礎時, 也能充分展現其功效。
符合無鉛相關環保規範
為善盡環境保護責任,本公司採用不含氰及鉛等RoHS規範所明定有害物質之環保藥液